集積回路不具合解析
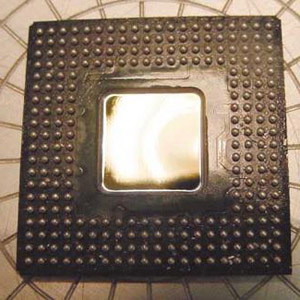
故障解析技術は統合回路の故障の原因を特定するために使用されます。
アプリケーションカタログをリクエストする故障解析用途で膜厚測定を要する主な例は、正面剥離(ディレイヤリング:従来のデバイス側を上にパッケージされたIC)と、裏面研削(シニング:新しいタイプのデバイス側を下にパッケージされたIC)です。
正面剥離
正面剥離プロセスでは、誘電層研削後に残っている誘電層の厚みを知る必要があります。 フィルメトリクスのF40は、この用途に最適です。
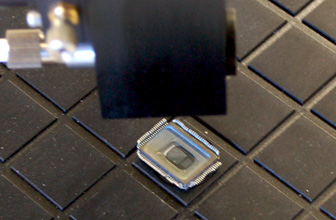
測定例
ここでは、集積回路ICの裏面研削後に残っているシリコンの厚み測定に当社F3-s1550機種を用いられている。研磨後の膜や表面の粗いまたは膜の均一性が良くない膜層の測定にも、10um以下測定スポット径の特殊光学系を使用したF3-s1550装置がとても適切だった。
測定セットアップ:
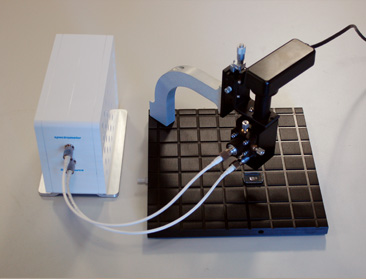
お問い合わせ
アプリケーションを検索する
-
アモルファスとポリシリコン
膜厚測定、結晶化度、全てのアモルファスとポリシリコンの屈折率と消衰係数
APPLICATIONS_amorphous-poly-silicon_FilterKeywords
-
CMP
F80膜厚測定システムは、酸化物、STI、金属CMPプロセスの測定に使用されています。
APPLICATIONS_cmp_FilterKeywords
-
誘電体
フィルメトリクスは産業界で使用される数千もの誘導体膜の測定システムを取り揃えています。
APPLICATIONS_dielectrics_FilterKeywords
-
ハードコート厚
フィルメトリクスのシステムはハードコートやプライマー厚を測定する自動車業界で幅広く使用されています。
APPLICATIONS_hardcoat-thickness_FilterKeywords
-
IC故障解析
F3-s1550はシリコンの裏面シニング測定をするチップ産業で使用されています。
APPLICATIONS_failure-analysis_FilterKeywords
-
ITOとその他のTCO
当社独自の解析アルゴリズムにより、TCO厚、屈折率、消衰係数の測定が測定ボタン一つで可能です。
APPLICATIONS_ito_FilterKeywords
-
医療デバイス
血管形成バルーン、ステント、インプラントコーティング、その他多数の膜厚を測定します。
APPLICATIONS_biomedical_FilterKeywords
-
金属膜厚測定
金属膜の膜厚、屈折率、消衰係数を50nmまで測定します。
APPLICATIONS_metal_FilterKeywords
-
OLED
NPB、lQ3、PEDOT、P3HT、soluble Teflons等の膜厚と屈折率を測定します。
APPLICATIONS_oled_FilterKeywords
-
眼鏡コーティング
F10-ARで屈折率、色、反射防止、ハードコート層厚の測定が可能です。
APPLICATIONS_ophthalmic_FilterKeywords
-
Paryleneコーティング
ParyleneコーティングサンプルをF3-CSのステージ上に置くだけで膜厚の測定が可能です。
APPLICATIONS_parylene_FilterKeywords
-
フォトレジスト
当社は数十もの異なるレジストを測定しており、屈折率ファイルもお使いのレジストに応じて作成できます。
APPLICATIONS_photoresist_FilterKeywords
-
多孔質シリコン
多孔質シリコン膜の膜厚、多孔率、屈折率、消衰係数を測定します。
APPLICATIONS_porous-silicon_FilterKeywords
-
プロセス膜
フィルメトリクスは半導体プロセス膜の測定用に完全なシステムを取り揃えています。
APPLICATIONS_process-films_FilterKeywords
-
屈折率と消衰係数
190-1700nm範囲の屈折率と消衰係数を測定
APPLICATIONS_refractive-index_FilterKeywords
-
シリコンウエハーと膜
フィルメトリクスはシリコンを2mm厚まで測定する為の卓上、マッピング、製造システムを取り揃えています。
APPLICATIONS_si-wafers_FilterKeywords
-
ソーラーアプリケーション
CdTe、CdS、CIGS、アモルファスシリコン、TCO、反射防止層、その他の膜厚を測定します。
APPLICATIONS_solar_FilterKeywords
-
半導体教育研究機関
50台以上のF20が大学機関研究所で使用されています。
APPLICATIONS_teaching-labs_FilterKeywords
-
ウェブコーティング
フィルメトリクスのシステムはインラインのポリマー膜厚測定用に幅広く使用されています。
APPLICATIONS_web-coatings_FilterKeywords


